МДП-транзисторы с встроенным каналом
ПОЛЕВЫЕ ТРАНЗИСТОРЫ
Полевые транзисторы – FET (Field Effect Transistors). Принцип действия полевых транзисторов заключается в управлении проводимостью полупроводникового каналас помощью электрического поля, создаваемого потенциаломназатворе.Ток канала обусловлен дрейфом основных зарядов (электронов в n-канале или дырок в p-канале), поэтому полевые транзисторы называют униполярными.
Два типа полевых транзисторов выделяются по способуизоляциизатвора от канала.
Полевые транзисторы с управляющим p-n переходом (Шокли В. -1952 г.).
МДП транзисторы — структура металл –диэлектрик- полупроводник (Хофштейн С, Хейман Ф, -1963 г.)
2.4.1. Полевые транзисторы с управляющим p-n переходом. Конструкция. Принцип действия.
Управление величиной тока осуществляется за счёт изменения удельной проводимости и площади полупроводникового слоя – канала – с помощью электрического поля. В зависимости от типа проводимости канала различают транзисторы с каналом n-типа и транзисторы с каналом p-типа. Управляющий электрод изолируется от канала с помощью диэлектрика (окисла кремния) или с помощью обратно-смещённого p-n перехода. Конструктивное выполнение полевого транзистора с p-n переходом и каналом n-типа приведено на рис. 2.4.1. Транзистор изготовлен на основе кристалла кремния n-типа проводимости. На торцах кристалла расположены электроды. Электрод, от которого начинается движение носителей (в канале n-типа – электроны), называется истоком, а электрод, к которому движутся носители – стоком. Для того, чтобы носители двигались от истока к стоку, на сток транзистора с n-каналом нужно подать положительное напряжение относительно истока. С боковых сторон кристалла путём легирования акцепторной примесью образованы области p-типа. Электрод, связанный с областями p-типа, называется затвором.
Между каналом n-типа и слоями p-типа образуются p-n переходы – области объёмных зарядов ионов примеси, обеднённые подвижными носителями заряда и обладающие поэтому низкой проводимостью.
Ширина канала определяется в соответствии с рис.2.4.1:
где a – расстояние между слоями p-типа;
l – ширина перехода.
Концентрация примеси в p-слое значительно (на несколько порядков) больше, чем в n-канале, поэтому p-n переход распространяется в n-слой и его ширина

ширина проводящего слоя-канала

 |

При увеличении отрицательного напряжения на затворе ширина канала уменьшается и при некотором напряжении становится равной нулю – обеднённые слои смыкаются между собой и проводящий канал перекрывается. Напряжение затвора, при котором канал перекрывается и проводимость канала близка к нулю (ток отсекается), называется напряжением отсечки Uзи отс. Если к затвору приложить положительное напряжение относительно истока, то ширина p-n переходов уменьшается, а w и проводимость канала возрастают. Возможное положительное значение Uзи составляет 0,2 – 0,3В, т.к. при больших напряжениях открываются p-n переходы, резко увеличивается ток затвора. Для транзисторов с p-n переходом и каналом n-типа рабочие напряжения на затворе Uзиотс≤Uзи≤0, а для транзисторов с каналом p-типа Uзи отс>0 и 0≤Uзи≤Uзи отс.
Если приложить к стоку относительно истока положительное напряжение, то через канал начинает протекать ток за счёт движения электронов от истока к стоку. При постоянном напряжении на затворе потенциал канала относительно затвора становится более положительным. У истока напряжение на p-n переходе равно Uзи , а у стока Uзс=Uзи—Uси. Например, если Uзи=-1В, а Uси=+2В, то Uзс=-1В-2В=-3В. По мере приближения к стоку к p-n переходу прикладывается всё более отрицательное напряжение (обратное) и ширина l возрастает, а ширина w=a−2l уменьшается. Канал перекрывается таким образом по двум причинам: под действием управляющего напряжения на затворе канал сужается по всей длине равномерно; под действием напряжения на стоке канал сужается по мере приближения к стоку. На рис.2.4.2 изображено сечение канала для различных Uзи и Uси. Из рисунков видно, что чем больше напряжение на затворе (по абсолютной величине), тем меньше начальная ширина и проводимость канала, и тем меньше напряжение Uси, при котором канал перекрывается. Если Uси≥|Uзи отс|, то канал перекроется у стока и при Uзи=0, когда ширина канала у истока максимальна.
График 1 на рис.2.4.2 соответствует высокой проводимости канала, а графики 2,3,4 – низкой проводимости (канал перекрыт). Перекрытие канала приводит к резкому возрастанию дифференциального сопротивления канала и слабой зависимости тока от приложенного к каналу напряжения Uси.
Рис. 2.4. 2. Смыкание высокоомных слоёв и перекрытие канала
В таблице 2.4.1 приводятся условные графические изображения полевых транзисторов с p-n переходом и каналами n— и p-типа с указанием полярности рабочих напряжений и положительных направлений токов.
| Графическое изображение | Тип канала и полярности напряжений | |
 | Канал n-типа. Напряжение на стоке положительное относительно истока, на затворе – отрицательное: Uси>0, Uзи≤0. | |
 | Канал p-типа. Напряжение на стоке отрицательное относительно истока, на затворе – положительное: Uси 0. Схема замещения полевого транзистора в режиме малого сигнала приведена на рис.2.4.5. Рис. 2.4. 5. Схема замещения полевого транзистора В полевом транзисторе отсутствуют процессы инжекции и накопления неосновных носителей. Поэтому быстродействие и частотные свойства определяются процессами перезаряда барьерных ёмкостей управляющих p-n переходов. Входное сопротивление Rзи на постоянном токе представляет собой сопротивление обратносмещённого p-n перехода и по величине составляет 10 8 -10 9 Ом. Ёмкости для маломощных транзисторов, имеющих малые площади p-n переходов, составляют единицы пикофарад. Источник тока SUзи отражает усилительные свойства транзистора. Внутренне сопротивление источника RI на высоких частотах шунтируется ёмкостью Сси. При работе транзистора от высокоомного источника сигнала частотный диапазон ограничен временем перезаряда входной ёмкости Сзи через сопротивление источника сигнала. Проходная ёмкость Сзс образует частотозависимую обратную связь, уменьшающую усиление на высоких частотах. Поэтому ёмкость Сзс стараются технологически уменьшать. Полевые транзисторы используются в трёх основных схемах включения. Усилительный каскад в схеме с общим истоком обеспечивает усиление по напряжению и мощности, коэффициент усиления по напряжению Схема с общим стоком – истоковый повторитель обеспечивает коэффициент передачи по напряжению примерно равный единице, большое входное сопротивление и низкое выходное Схема с общим затвором имеет низкое входное сопротивление – примерно Rси0. Такое включение транзистора используется для построения источников тока и высококачественных повторителей тока, так как из-за очень малого значения токов утечки затвора с высокой степенью точности выполняется условие IС=IИ. МДП-транзисторы с встроенным каналом В полевых МДП−транзисторах металлический затвор изолирован от полупроводникового канала диэлектриком, т.е. транзистор представляет собой структуру металл−диэлектрик−полупроводник – МДП. Наиболее распространён диэлектрик оксид кремния, поэтому такие транзисторы часто называют МОП−транзисторы. Различают МДП−транзисторы с встроенным каналом и индуцированным каналом. В МДП−транзисторах с встроенным каналом канал создаётся технологически. Основой МДП−транзистора является подложка слаболегированного кремния. В теле подложки создаются сильнолегированные области другого типа проводимости, соединённые каналом того же типа проводимости. В зависимости от типа проводимости различают транзисторы с каналом n−типа и p−типа. Наиболее распространены по технологическим причинам транзисторы с встроенным каналом n−типа – рис.2.4.6. В теле подложки – кристалла кремния p−типа проводимости – созданы две сильнолегированные области n−типа проводимости, соединённые каналом n−типа. Одна из областей n−типа является истоком, а другая – стоком. Электрод затвора изолирован от канала тонким слоем диэлектрика. Если приложить между стоком и истоком напряжение, положительное на стоке относительно истока, то через канал будет протекать ток, обусловленный начальной проводимостью канала. Если к затвору приложить положительное напряжение относительно истока, то электроны будут притягиваться из полупроводника к затвору, проводимость канала увеличивается, ток через транзистор возрастает. Такой режим работы при Uзи>0 для транзистора со встроенным каналом n−типа называется обогащением. При подаче на затвор отрицательного напряжения относительно истока дырки притягиваются из подложки, а электроны отталкиваются из канал, происходит обеднение канала основными носителями – электронами, проводимость канала уменьшается. При некотором отрицательном напряжении Uзи=Uотс, называемом напряжением отсечки, происходит инверсия типа электропроводности канала: n + −области будут разделены слоем p−типа проводимости. Ток стока определяется обратным током p−n перехода, образованного n + −слоем и p−слоем подложки. При протекании тока через канал от стока к истоку (движение электронов в обратном направлении) потенциал канала становится более положительным относительно затвора по мере приближения к стоку, что равносильно подаче на соответствующий участок затвора отрицательного напряжения. Поэтому канал сужается к стоку и при Uси≥|Uотс| канал перекрывается.
Рис. 2.4. 6. МДП−транзистор с встроенным каналом n−типа На рис.2.4.7 приведено семейство стоковых характеристик Стоковые характеристики содержат участок линейного нарастания тока стока и участок насыщения (ограничения) тока стока. Переход от одного участка к другому обусловлен смыканием канала у стока. Рис. 2.4. 7. Стоковые характеристики МДП−транзистора с встроенным каналом n−типа На рис.2.4.8 изображён вид канала для характерных точек стоковой характеристики. В общем случае потенциал участка канала, прилегающего к затвору, относительно затвора равен Uси−Uзи. На линейном (омическом участке) при Uзи=0, Uси 0 соответственно увеличивается ток насыщения транзистора – т.8, перекрытие канала происходит при большем напряжении Uси – т.9, а линейный участок более крутой – т.10. Рис. 2.4. 8. Вид канала МДП транзистора с встроенным каналом 6. Uси 0 Обогащение канала 10. Uси 0 канал обогащается носителями n−типа, при Uзи |Uотс| происходит инверсия типа проводимости приповерхностного слоя, канал n−типа исчезает, ток Iс практически равен нулю. Протекает лишь малый ток обратно−смещённого перехода, образованного n + −областью стока и p−областью подложки. Для предотвращения протекания прямых токов p−n переходов исток−подложка и сток−подложка к электроду подложки p−типа подключают отрицательное напряжение, а к подложке n−типа – положительное. Иногда при помещении кристалла в корпус электрод подложки соединяют с истоком. Параметры полевого транзистораВВЕДЕНИЕ При проектировании МОП полевого транзистора (МОП ПТ), входящего в состав интегральной микросхемы (ИМС), необходимо учитывать электрофизические параметры исходной кремниевой подложки, конструктивные и электрические параметры МОП полевого транзистора, их связь между собой. К электрофизическим параметрам кремния, влияющим на характеристики полевого транзистора, относятся кристаллографическая ориентация и тип электропроводности кремниевой подложки, концентрация исходной примеси в ней, степени легирования канала, областей стока и истока. На характеристики прибора также значительное влияние оказывают материал, который используется в качестве подзатворного диэлектрика (и, прежде всего, величина его диэлектрической проницаемости). Выбор материала, который используется в качестве затвора, определяется материалом подзатворного диэлектрика, типом проводимости канала и соотношением работы выхода материала затвора с работой выхода полупроводника. Основными конструктивными параметрами МОП полевого транзистора являются: эффективная длина канала lэфф (или L кан эфф ) и длина затвора lз (или L кан ), определяемая по фотомаске, ширина канала b, толщина подзатворного диэлектрика lox (или hox ). Остальные конструктивные параметры (размеры областей стока и истока, глубина залегания p-n переходов данных областей) определяются при проектировании как по технологическим ограничениям на размеры МОП- структуры, так и связью геометрических параметров с электрофизическими (например, влиянием глубины залегания p-n переходов стока и истока на величину переходного и контактного сопротивления канала). Упрощенная модель конструкции типового МОП-полевого транзистора представлена на рис. 1. Рис. 1. Упрощенная модель n-канального МОП ПТ [1] К основным электрическим параметрам и характеристикам МОП-полевых транзисторов относятся: пороговое напряжения прибора Uпор, стоковая и сток-затворная характеристики, крутизна S на линейном и пологом участках ВАХ, удельная крутизна So, дифференциальное сопротивление канала Rк (или проводимость канала gc) ; входное сопротивление Rвх; паразитные межэлектродные емкости затвор-подложка Cзп, затвор-исток Cзи, затвор-сток Cзс, сток-исток Cси, исток-подложка Cип, сток-подложка Cсп и ряд других параметров. На рисунках 2 — 5 [3] представлена упрощенная модель работы n-канального МОП-транзистора обогащенного типа при различных условиях смещения на его выводах [2]. (На начальном этапе образования канала можно не учитывать влияния заряда поверхностных состояний Qss на границе раздела кремний-SiO2 и разности работ выхода материалов затвора, подзатворного диэлектрика и кремния). Хотя МОП полевой транзистор может работать как прибор с четырьмя выводами, рассмотрим ситуацию, когда исток и подложка заземлены. Сначала предположим, что напряжение на стоке Uc = 0 и рассмотрим эффекты, вызванные изменением напряжения на затворе U3. При нулевом напряжении на затворе у идеализированного n-канального прибора обогащенного типа под затвором в области на границе раздела кремний-SiO2 находится материал р-типа проводимости. При этом на границах раздела стока и истока транзистора с подложкой противоположенного типа проводимости возникают некоторые по протяженности области пространственного заряда (области обеднения), величина которых определяется, в основном, степенями легирования соответствующих n- и р-областей (см. рис.2). По мере увеличения положительного напряжения на затворе дырки в р-Si начинают «оттесняться» электрическим полем затвора от поверхности раздела кремний-SiO2, оставляя заряженные неподвижные ионы примеси. Данные ионы примеси начинают формировать обедненный слой под поверхностью раздела окисл-кремний. Электрическое поле, берущее свое начало на затворе, заканчивается на этих заряженных ионах. При увеличении напряжения на затворе толщина обедненного слоя увеличивается. Одновременно с этим происходит инжекция подвижных электронов из областей стока и истока, которые притягиваются к границе раздела Si-SiO2 . После того, как начинается образование слоя подвижных электронов, ширина обедненного слоя ионов будет оставаться практически постоянной, так как ее действие начинает компенсироваться зарядом подвижных электронов в формирующемся канале прибора. Эта ситуация показана на рис. 3. При дальнейшем увеличении напряжения на затворе концентрация электронов в формирующемся канале становится больше равновесной концентрации дырок pp0. Таким образом, в р-кремнии на границе раздела кремний-SiO2 возникает инверсия проводимости в приповерхностном слое. Для количественной характеристики процесса инверсии принимается, что поверхностный потенциал Φs (или электростатический потенциал на поверхности полупроводника, отсчитываемый от середины запрещенной зоны) равен удвоенному значению потенциала уровня Ферми, т.е. Состояние полупроводника, при котором называется режимом сильной инверсии, а напряжение на затворе, при котором возник режим сильной инверсии, получило название пороговое напряжение МОП-структуры. Величина порогового напряжения складывается из нескольких составляющих: Uок — падение напряжения на окисле, определяется свойствами подзатворного диэлектрика, т.е., его толщиной и величиной диэлектрической проницаемости; Usi. — в режиме сильной инверсии часть напряжения падает на окисле, вторая часть напряжения падает на обедненном слое кремния, образованным под каналом зарядом ионизированной примеси при действии напряжения на затворе. Протяженность обедненной области и величина заряда в ней определяется, прежде всего, степенью легирования полупроводника на границе радела с SiO2. |Uss| — составляющая в пороговом напряжении, которая должна компенсировать заряд положительных поверхностных состояний, возникаюших на границе раздела окисел-кремний при выращивании SiO2. Величина заряда в основном определяется кристаллографической ориентацией подложки, на которой выращивается подзатворный диэлектрик; Uw – составляющая в пороговом напряжении, которая компенсирует искривление энергетических зон в кремнии, вызванное разностями в работах выхода между материалами затвора и диэлектрика, диэлектрика и полупроводника. Если к затвору прибора приложено напряжение, достаточное для того, чтобы вызвать сильную инверсию, то одна часть этого напряжения падает на слое окисла (Uox), а другая — на обедненном слое кремния (Usi). Из-за положительных поверхностных состояний в подзатворном диэлектрике существует положительный поверхностный заряд Qss, для учета влияния которого требуется отрицательная составляющая (-Uss) в величине Uпор. Разности работ выхода в полупроводнике, окисле и в материале затвора вызывает дополнительное искривление энергетических зон, что компенсируется составляющей Uw. При Uз, большем Uпор в обедненном слое существует заряд отрицательных ионов, а в канале есть заметный заряд подвижных электронов. Обедненный слой на рисунке закрашен желтым цветом (рис. 3). Между обедненным слоем и плоскостью раздела Si-SiO2 существует канал с равномерно распределенной концентрацией электронов (заштрихован). Теперь можно использовать подвижный заряд в канале, прикладывая к стоку полевого транзистора положительное напряжение (рис. 4). Это напряжение вызывает ток электронов от истока к стоку. Сила этого тока регулируется напряжением на затворе. Прибор должен рассматриваться в двух измерениях, так как имеются вертикальное электрическое поле из-за разности потенциалов между затвором и подложкой и горизонтальное электрическое поле из-за разности потенциалов между истоком и стоком (рис. 1). Эти электрические поля взаимодействуют, и в результате взаимодействия толщина обедненного слоя от истока к стоку увеличивается, а толщина канала уменьшается. Это ситуация показана на рис. 4. Напряжение стока создает обратное смещение на p-n переходе сток-подложка, которое приводит к увеличению толщины обедненного слоя. Напряжение сток — исток проявляется как горизонтальное падение напряжения на сопротивлении канала Rк, вызванное протеканием тока Iк вдоль канала (Iк·Rк). Оно является причиной уменьшения напряжения между затвором и подложкой и приводит к сужению канала вблизи стока. На рис. 4 показана работа МОП ПТ при условии Это напряжение является минимально достаточным для того, чтобы вблизи стока поддерживалась сильная инверсия. При дальнейшем росте напряжения на стоке участок канала вблизи стока перекроется и «исчезнет», поскольку напряжение между затвором и подложкой на этом участке станет недостаточным для поддержания режима сильной инверсии. Из-за увеличения на этом участке обратного смещения на стоке увеличится толщина обедненного слоя. Между местом перекрытия канала и стоком существует электрическое поле. Оно вытягивает подвижные носители заряда из канала к стоку: данная ситуация показана на рис. 5. Область рабочих параметров прибора, в которой канал существует от истока до стока, называется линейной областью или линейным участком, а область, в которой канал перекрыт, называется областью, или участком насыщения. На линейном участке увеличение Uc ведет к увеличению тока в канале. В области насыщения ток канала остается постоянным, несмотря на дальнейшее увеличение Uc. Рост Uc проявляется в расширении обедненной области, а сила тока определяется сопротивлением оставшейся части канала. По мере возрастания Uc длина канала немного уменьшается из-за расширения области перехода сток-подложка во всех направлениях. Канал укорачивается (снижается Rc) и вместе с тем несколько растет ток Ic. Это явление называется модуляцией длины канала. Оно является причиной того, что величина выходного сопротивления МОП полевого транзистора имеет предельное значение. На рис. 6 показано семейство выходных характеристик для n- канального МОП полевого транзистора обогащенного типа. Штрихпунктирная линия отделяет линейные участки ВАХ от областей насыщения. Эта линия отделяет область сильной инверсии от области перекрытия канала, поэтому ее уравнение имеет вид: Область насыщения . Ситуация, показанная на рис. 5, когда канал прибора перекрыт, и ток стока практически не меняется, несмотря на увеличения напряжения на стоке, соответствует на ВАХ области насыщения. Ток канала ограничивается в основном экстракцией носителей заряда через область обеднения стока, а сопротивление канала в этой области стремится к бесконечности. Модуляция длины канала за счет увеличения области обеднения стока приводит к незначительному увеличению тока стока. Рис. 6. Семейство типичных зависимостей тока стока от напряжения на стоке, Ic = f ( Uc ) для n-канального МОП ПТ обогащенного типа при различных напряжениях на затворе Uз [2] Линейная область. Область ВАХ от момента формирования канала до его отсечки называется линейной, т.е. канал в этой области существует, и ток стока практически линейно увеличивается с напряжением на стоке. (МОП ПТ можно рассматривать на этом участке как линейный резистор, управляемый напряжением). Область насыщения от линейной области отделяет штрихпунктирная линия Uc = U з – U пор . Область пробоя. При дальнейшем увеличении напряжения на стоке происходит лавинный пробой обратно-смещенного p-n перехода. Для полевого транзистора c длинным каналом характерен лавинный пробой стокового перехода. Особенностью пробоя полевого транзистора является то, что наихудшие условия (малые значения напряжения пробоя) соответствуют отключённому затвору. Высокое входное сопротивление полевого транзистора способствует пробою подзатворного окисла зарядом, накапливаемым ёмкостью затвора, при относительно низких напряжениях. Например, при толщине окисла l ок = 0,05 мкм напряжение пробоя Uпроб составляет всего 50 В. Такое напряжение может быть легко создано статическим зарядом, накапливающемся на теле экспериментатора. Область подпороговых характеристик. При рассмотрении работы прибора предполагалось, что при напряжении затвора U з к стоку, между истоком и стоком создана небольшая разность потенциалов. Рис. 7. Упрощенная физическая модель n-канального МОП-транзистора обогащенного типа. b – ширина канала, xj – глубина залегания p-n переходов областей стока и истока, lox – толщина подзатворного диэлектрика Между затвором и каналом существует вертикальное электрическое поле Еy, а в канале существует горизонтальное электрическое поле между истоком и стоком Ех. Из-за взаимодействия этих полей задача вывода вольт-амперных характеристик становится двумерной. Вывод можно упростить предположением, что глубина канала «крайне невелика». Задача распадется на две одномерные задачи. Рассмотрим вертикальное электрическое поле в слое окисла для нахождения плотности подвижного заряда в произвольном участке канала. Зная эту плотность, найдем выражение для горизонтального тока в канале от истока к стоку как функцию напряжений Uc = U3. Обратимся к рис. 7. Пусть потенциал канала на расстоянии х от истока будет U(x). Чтобы имела место инверсия, падение напряжения на слое окисла должно превосходить пороговое напряжение Uпор. Поэтому Заряд, наведенный в полупроводнике, состоит из граничных отрицательных ионов Qb и подвижных электронов Qm. В условиях равновесия этот заряд равен заряду на затворе. По теореме Гаусса, полный поток вектора напряженности поля в направлении нормали к затвору численно равен плотности поверхностного заряда. Поэтому где Предположим, что существует равномерный слой зарядов толщиной y0. Объемную плотность зарядов pv(x) можно теперь выразить в виде Плотность где Объединяя формулы (9-7) и (9-9), получим Плотность тока, удельная проводимость и величина электрического поля в данной точке связаны законом Ома: Если считать, что в связи с падением напряжения в канале IR напряжение в канале меняется только в направлении х, то где А — есть площадь поперечного сечения канала. Из рис. 9.6 видно, что площадь поперечного сечения канала Ток стока через канал должен быть постоянным в каждой точке x , поэтому Подставляя (9-10) в (9-16), имеем: Формулу (9-19) можно переписать в виде Это уравнение описывает работу прибора на линейном участке. Оно справедливо лишь для той области значений параметров, в которой инверсионный слой существует от истока до стока. Другими словами, формула верна для тех значений параметров, при которых При канал вблизи области стока исчезнет, поскольку величина напряжения затвор – канал на этом участке окажется недостаточной для поддержания режима сильной инверсии. РАБОТА МОП ПОЛЕВОГО ТРАНЗИСТОРА В ОБЛАСТИ НАСЫЩЕНИЯ При условии Если подставить это выражение в (9-24) , то получим Примечание. В выражениях (9-5) – (9-27) b – ширина канала, L – длина канала, lox – толщина диэлектрика, µ s – поверхностная подвижность носителей заряда, Сок – емкость подзатворного диэлектрика, U ЗИ – напряжение затвор-исток, U пор – пороговое напряжение МОП структуры, U СИ – напряжение сток-исток. Из формулы (9-27) видно, что при постоянном напряжении на затворе Uз ток стока Ic также будет постоянным, т.е. ток стока не зависит от напряжения стока Uc. Кроме этого из (9-27) следует, что между током стока и напряжением Особенности выходных стоковых характеристик Проводимость канала gк — есть производная стоковой характеристики (дифференциальная проводимость) в начале координат. Она имеет смысл начальной проводимости канала, поскольку устанавливается напряжением затвора и является проводимостью канала, по которому ещё не проходит ток. Начальная проводимость соответствует равномерному распределению электронов по длине канала. Проводимость канала определяется тангенсом угла наклона стоковой характеристики при Uси = 0. Поэтому кривые выходят из начала координат под разными углами, пропорциональными напряжению затвора (рис. 6). Стоковые характеристики идеального транзистора рассчитываются в предположении, что подвижность носителей в канале μS не зависит от напряжённости поперечного электрического поля Ex , создаваемого затвором. Однако экспериментальные результаты показывают значительную зависимость продольной поверхностной подвижности μS от поперечного электрического поля, что существенно влияет на характеристики реальных приборов (рис. 8 и 9). Рис. 8. Эффективная подвижность электронов в канале при 300 К и 77 К в зависимости от поперечной составляющей напряженности электрического поля для различных значений концентрации примеси NA в подложке [4] Рис. 9. Экспериментальная зависимость эффективной подвижности электронов и дырок в канале от эффективной поперечной составляющей напряженности электрического поля Еэфф[4] Из-за наличия на поверхности раздела кремний-диэлектрик большого количества центров рассеяния поверхностная подвижность носителей в канале обычно в 2–3 раза меньше объёмной. Например, у кремния поверхностная подвижность электронов при комнатной температуре составляет 400–700 см 2 ( В·c) -1 , в то время как объёмная равна 1300 см 2 ( В·c) -1 . Объёмная подвижность электронов в германии 3800 см 2 ( В·c) -1 , в арсениде галлия – 8500 см 2 ( В·c) -1 . При больших значениях напряжённости продольного поля Ey дрейфовая скорость достигает насыщения (рис. 10). При этом, величина скорости насыщения зависит от нескольких факторов: от поперечного электрического поля Ex (с увеличением напряжённости поперечного электрического поля, уменьшении толщины подзатворного диэлектрика, значение продольной скорости насыщения уменьшается.. Зависимость дрейфовой скорости от поперечного поля вызывает, во-первых, значительное уменьшение тока насыщения МОП ПТ и, во-вторых, не создаёт квадратичную, как предсказывает теория идеальных полевых транзисторов, зависимость тока насыщения от напряжения на затворе. Рис. 10. Теоретические зависимости дрейфовой скорости электронов на границе раздела Si-SiO2 от напряженности электрического поля для трех значений толщины подзатворного диэлектрика lox (пороговое напряжение U пор 0,7 В, U затв – U пор = 2 В) [4] Стоковые характеристики полевого транзистора со встроенным каналом. Вид характеристик приборов с индуцированным и встроенным каналами очень похож, однако, если для нормальной работы ПТ с индуцированным каналом нужно приложить к затвору достаточно большое напряжение Uз ≥ Uпор , то полевой транзистор со встроенным каналом открыт уже при нулевом напряжении на затворе. Как уже отмечалось, при напряжении Uси = Uзи − Uпор = UСнас ток стока равен току насыщения: Это соотношение представляет собой сток-затворную характеристику – зависимость тока стока в области насыщения от напряжения затвора при фиксированном напряжении стока. Семейства сток-затворных характеристик полевого транзистора с индуцированным и встроенным каналами приведены на рис. 11. Параметром семейств является напряжение стока. Встроенный токопроводящий канал под затвором МОП ПТ может быть создан как технологическими методами в процессе производства, так и за счёт напряжения плоских зон – фиксированного заряда поверхности раздела Si — SiO 2 и контактной разности потенциалов между металлом затвора и полупроводником подложки. Встроенный токопроводящий канал обязательно сопровождается наличием встроенного p – n- перехода подложка-область канала. Если полярность напряжения на затворе соответствует обратному смещению этого p – n- перехода ( U З > 0 для n -канала и p -подложки, и U З 0 , соответствующем обратному смещению встроенного p–n-перехода, полевой транзистор работает в режиме обогащения. Ток стока увеличивается. При Uз Uпор , причём только при напряжении одной полярности: UЗ > 0 для п-канального полевого транзистора на р-подложке (рис. 4), и — Ёмкости перекрытия областей затвор-исток CЗИ и затвор–сток CЗС ( C перекр) образуются за счёт того, что затвор и слой подзатворного окисла частично перекрывают края областей истока и стока, где Перекрытие затвора и областей обеднения стока и истока принципиально необходимо для полевого транзистора с индуцированным каналом. В противном случае непрерывный канал не будет сформирован. Величина перекрытия δl должна быть минимальной, чтобы минимизировать эти ёмкости. — Барьерные ёмкости истокового Cбар-Исток и стокового Cбар-Сток переходов присущи физической структуре полевого транзистора. Они зависят от площадей п+ областей стока и истока, и концентрации примесей в подложке. Для уменьшения барьерной ёмкости легирование подложки должна быть небольшим. Предельная частот работы прибора Идеальный МОП ПТ представляет собой усилитель с бесконечным входным сопротивлением и генератором тока. Для анализа электрических характеристик используется эквивалентная схема замещения. На рис. ? представлена схема для включения МОП ПТ с общим истоком. Максимальное быстродействие прибора определяется минимально необходимым временем формирования канала, т.е. временем заполнения канала электронами или, выражаясь схемным языком, временем заряда ёмкости затвор–канал. Очевидно также, что быстродействие МОП полевого транзистора всегда будет ограничено временем пролёта носителей заряда в канале. Рис. 13. Эквивалентная схема замещения МОП-структуры [ 2] Входная проводимость g вх определяется током утечки через тонкий подзатворный диэлектрик, очень часто данной составляющей пренебрегают в силу ее незначительности. Входная емкость Cзи представляет емкость между затвором и истоком. Достаточно часто она составляет до двух третей емкости затвор-окисел Cox . Сзс – это емкость между затвором и стоком, и обычно она меньше по величине, чем Сзи. Так как в реальных приборах затвор частично перекрывает края областей стока и истока, то этот эффект дает дополнительный вклад в емкости Сзи и C зс по сравнению с теми значениями, которые бы были без такого перекрытия. Выходная проводимость gc равна проводимости канала прибора. Выходная емкость C си представляет, главным образом, емкости стока и истока. Если нет соединения истока с подложкой, то Сси представляет емкости переходов двух обратно-смещенных диодов: p-n перехода исток — подложка , и p-n перехода сток — подложка, последовательно соединенных через объем полупроводниковой пластины. Если такое соединение есть, то Сси представляет просто емкость p-n перехода сток — подложка. Величина gm представляет крутизну характеристики прибора, а gc – проводимость канала. Из-за нелинейности характеристик МОП ПТ все элементы схемы являются дифференциальными элементами и их величины зависят от конкретного режима работы прибора. Максимальную рабочую частот для представленной модели можно определить, как частоту, при которой ток заряда емкости Сзи будет равен будет равен току зависимого источника тока – (gm·Uз), то есть: Если принять, что То, подставляя значения Реальная предельная частота МОП полевого транзистора оказывается существенно ниже, чем та, которая может быть расчитана из уравнения (10). Если воспользоваться предыдущим уравнением (8), и учесть, что в сильных полях происходит насыщение дрейфовой скорости носителей заряда, который приводит к существенному снижению тока стока, в результате чего он становится примерно пропорциональным напряжению на затворе, а не квадратичен, как предсказывает теория [2, стр. 27], то крутизна в режиме насыщения оказывается постоянной и равной: где Данная предельная частота соответствует времени пролета в канале носителем заряда со скоростью насыщения: Наример, расчет показывает, что для прибора с длиной канала L = 0,1 мкм и Следует иметь в виду, что увеличение ширины канала и уменьшение толщины подзатворного диэлектрика увеличивает ёмкость затвор–канал, что снижает быстродействие. Температурные зависимости параметров прибора Температура влияет особенно заметно на подвижность, пороговое напряжение и форму подпорогового участка ВАХ. При напряжениях на затворе, обеспечивающих сильную инверсию, подвижность инверсионных носителей при Т > 300 К уменьшается с температурой по закону Т -2 . С понижением температуры характеристики транзистора улучшаются. Так при уменьшении температуры от 296 К до 77 К пороговое напряжение тестовой структуры (Lкан = 9 мкм) возросло от 0,25 до 0,5 В. Наиболее важным оказалось улучшение подпороговых характеристик: S-фактор, т.е. напряжение, вызывающее изменение подпорогового тока в 10 раз, уменьшился от 80 мВ/декаду при 296 К до 22 мВ/декаду при 77 К. такое практически четырехкратное уменьшение S обусловлено температурным множителем kT/q, входящим в формулу для S. Другим преимуществом является увеличение подвижности, и, как следствие, более высокая крутизна и проводимость в окрестности порогового напряжения, пониженное рассеяние мощности, сниженные токи утечки p-n переходов, снижение омического сопротивления шин металлизации. Следует учитывать, что при повышении температуры происходит экспоненциальный рост концентрации собственных электронов перебрасываемых в зону проводимости из валентной зоны за счёт энергии тепловых колебаний решётки (фононов). Повышение температуры увеличивает энергию фононов, что облегчает переход. Вместе с тем, увеличение концентрации электронов позволяет достичь состояния сильной инверсии при меньшей напряжённости электрического поля. В итоге температурные изменения крутизны могут быть компенсированы противоположными изменениями тока стока. ЭФФЕКТЫ КОРОТКОГО КАНАЛА По мере уменьшения длины канала многие характеристики МОП полевого транзистора начинают резко отличаться от рассмотренных для длинно-канальных приборов. Эти отличия обусловлены принципиально двумерным характером распределения электрических полей в канале, а для описания коротко-канального полевого транзистора уже нельзя использовать приближение плавного канала, когда предполагалось, что Ex >> Ey, и решаемая задача могла считаться одномерной. Следовательно, все полученные ранее зависимости, описывающие работу полевого транзистора, требуют уточнений и корректировок. Уменьшение толщины подзатворного диэлектрика, выполняемое в соответствии с принципами масштабирования параметров полевого транзистора, оказывает более значительное влияние на увеличение тока стока и крутизну, чем просто уменьшение длины канала, но, одновременно с этим, возросшая напряженность вертикальной составляющей электрического поля значительно снижает подвижность носителей заряда в канале. В ситуации, когда длина канала МОП ПТ уменьшается в результате масштабирования до значений порядка 100 и менее нанометров, необходимо рассматривать процессы, обобщенно называемые «эффектом короткого канала». В частности, уменьшение длины канала и перекрытие области обеднения канала с областями ОПЗ (обеднения) стока и истока приводит к тому, что напряжение на затворе должно управлять меньшим по величине зарядом, находящимся под затвором, что приводит к уменьшению порогового напряжения при уменьшении эффективной длины канала. При увеличении напряжения на стоке в короткоканальном приборе происходит проникновение поля стока в канал и при малой длине канала проникновение поля уменьшает высоту потенциального барьера на истоке прибора, увеличивая инжекцию носителей заряда в инверсионный канал (так называемый DIBL-эффект). Степень влияния данного эффекта определяется толщиной подзатворного диэлектрика, характером распределения примеси в канале и напряжением на стоке. Для короткого канала (если не предприняты специальные меры, например, создание слаболегированных областей стока, LDD, или SDE-областей), характерен прокол канала, когда происходит смыкание ОПЗ истокового и стокового переходов. Согласно [2], в качестве критерия короткого канала можно принять следующее условие: минимальная длина канала, L мин, при которой подпороговый участок ВАХ прибора еще сохраняет характерные черты длинно-канального определяется следующим эмпирическим соотношением: wc, wи – области обеднения (ОПЗ) стока и истока , вычисляемые в предположении одномерного резкого p-n перехода: NA – степень легирования канала, см -3 Uc – напряжение на стоке Vbi – контактная разность потенциалов перехода сток-канал, исток -канал Ubs — смещение на подложке. Как следует из (13) на тот факт, что прибор можно отнести к категории коротко-канальных и учитывать при описании его характеристик и свойств все ограничения, присущие приборам с коротким каналом, влияет целый ряд факторов. При этом к основным относятся: глубина залегания p-n переходов областей истока и стока, толщина подзатворного диэлектрика и величина его диэлектрической проницаемости, степени легирования области канала и областей стока-истока приборов, задание режимов его работы. Снижение подвижности носителей заряда Происходит из-за ряда факторов. При температурах свыше 300 К основным фактором является рассеяние на фононах (при условии хорошего качества границы раздела Si – SiO2). Также снижение подвижности происходит на микрорельефе поверхности раздела Si – SiO2.. При высокой концентрации примеси в канале существенный вклад дает рассеяние на кулоновских центрах, а также на заряженных поверхностных состояниях и заряженных ловушках в объеме SiO2. Снижение толщины подзатворного диэлектрика увеличивает напряженность вертикальной составляющей поля в канале до критических значений, при которых снижаются µn и µp. При малой напряженности электрического поля дрейфовая скорость носителей заряда линейно зависит от напряженности электрического поля. Однако, начиная с некоторого значения электрического поля, Екр, скорость носителей становится постоянной, то есть перестает зависеть от напряженности поля, что особенно наглядно проявляется в коротко-канальных прибора, так как относительное уменьшение длины канала L к происходит быстрее, чем уменьшение рабочего напряжения стока согласно моделям масштабирования. Насыщение дрейфовой скорости приводит к тому, что насыщение тока стока в коротко-канальном приборе происходит раньше, чем в длинно-канальном. Таким образом, граница на ВАХ между линейной областью и областью насыщения смещается левее. Усредненные значения скоростей насыщения составляют: (6 -10)·10 6 см/с для электронов и (4 — 8)·10 6 см/с для дырок. График насыщения дрейфовой скорости приведен на рис.10. Зависимости подвижностей ННЗ от напряженности поперечной составляющей поля приведены на рис. 8 и 9. В таблице ниже приведены усредненные значения подвижностей электронов и дырок для двух значений напряженности поля. Подвижность носителей заряда, см 2 /В·с Напряженность электрического поля | |
| 1,5· 10 6 В/см | 1,5· 10 7 В/см | |
| µn | 700 | 150 |
| µp | 140 | 35 |
В соответствии с принципами масштабирования электрических параметров и геометрических размеров МОП полевого транзистора критические напряженности поля можно снизить за счет уменьшения рабочих напряжений и, соответственно линейных размеров. Толщина подзатворного диэлектрика при снижении напряжений должна также уменьшаться и быть минимальной для эффективного управления процессами переноса носителей заряда в канале. При использовании в качестве подзатворного диэлектрика термически выращенной на подложке из Si двуокиси кремния в приборах с коротким каналом потребовалось уменьшения ее толщины до 2 – 3 нанометров [4]. При указанной толщине диэлектрик перестал удовлетворять своей основной характеристике – туннельные токи и токи утечки затвор-подложка через поры и несовершенства структуры SiO2 достигли столь высоких значений, что в ряде случаев суммарный вклад подпороговых токов и токов утечки достигал почти 30% в балансе всего энергопотребления ИМС.
Для сохранения эффективности управления переносом носителей в канале необходимо было сохранить неизменным значение емкости подзатворного окисла, Cox, которая определяется выражением:

Единственным способом сохранить величину емкости окисла при постоянном уменьшении lox – это использование в качестве подзатворного материала диэлектрика с более высоким, чем у SiO 2 значением диэлектрической проницаемости. То есть увеличение толщины диэлектрика для уменьшения токов утечки оказалось возможным при использовании материала с более высоким значением 





Достаточно часто для сопряжения различных по природе материалов, или для улучшения качества границы раздела диэлектрик-кремний под слоем собственно подзатворного диэлектрика выращивается термическим окислением очень тонкий (несколько десятков ангстрем) слой диоксида кремния. В случае двухслойного диэлектрика эквивалентную диэлектрическую проницаемость следует вычислять по формуле:




Материалы для затворов МОП полевых транзисторов с субмикронными
ПОЛЕВЫХ ТРАНЗИСТОРОВ
РАСЧЕТ ПАРАМЕТРОВ И ХАРАКТЕРИСТИК
Полевые транзисторы получают все более широкое распространение как в качестве дискретных элементов, так и в качестве элементов и компонентов интегральных микросхем. Главным достоинством полевых транзисторов является высокое входное сопротивление, обусловленное очень малым током затвора.
Существуют следующие разновидности полевых транзисторов:
— полевые транзисторы с р-n переходом (рис.5.1,а,б);
— полевые транзисторы с изолированным затвором, которые также называются МДП (металл-диэлектрик-полупроводник) или МОП (металл-оксид-полупроводник), в свою очередь, подразделяются на:
а) МДП — транзисторы с индуцированным каналом (рис. 5.1, в, г,)
б) МДП — транзисторы со встроенным каналом (рис.5.1, д, е,)
Полевые транзисторы бывают с каналом р- типа (см.рис. 5,1 а,в,д,) и с каналом n-типа (см.рис.5.1,б,г,е). Различие состоит в знаке используемых подвижных носителей заряда. При включении транзисторов с различными каналами в схемы, полярность подключения источников питания у них противоположная.
Ток утечки затвора, как уже отмечалось, очень мал. Например у транзистора КП103 Iз.ут≤20нА (при Uси=0 В, Uзи=10 В), у транзистора КП301Iз.ут≤0,3нА (при Uзи=-30 В).
Поэтому входные характеристики полевых транзисторов не рассматриваются.
Управляющее действие затвора наглядно иллюстрируют управляющие (стоко-затворные или переходные, проходные) характеристики выражающие зависимость.
Однако эти характеристики неудобны для расчетов, и поэтому чаще пользуются выходными характеристиками.
Выходные характеристики (стоковые) выражают зависимость (рис. 5.2)
Они показывают, что с увеличением Uси ток стока Ic сначала довольно быстро, а затем это нарастание замедляется и почти совсем прекращается, т.е. наступает явление, напоминающее насыщение. Работа транзистора обычно происходит на пологих участках характеристик, в области, которую не совсем удачно называют областью насыщения (на рис.5.2 отмечено пунктиром).
Напряжение, при котором начинается эта область, иногда называют напряжением насыщения. Запирающее напряжение затвора (при котором ток стока равен нулю Iс= 0) называют напряжением отсечки.
Типовые вольт-амперные характеристики представлены на рис. 5.3-5.5.
На рис. 5.3 — планарный полевой транзистор КП601 с управляющим р-n-переходом и каналом n-типа. На рис. 5.4 — кремниевый эпитаксиально планарный полевой транзистор КП717 с изолированным затвором индуцированным каналом (с обогащением канала) n-типа. На рис. 5.5 — диффузионно-планарный МДП- транзистор КП305 со встроенным канатом n-типа.
Полевой транзистор характеризуется следующими параметрами. Основным параметром является.
S — крутизна, отношение изменения тока стока к изменению напряжения на затворе при коротком замыкании по переменному току на выходе транзистора в схеме с общим истоком
Вторым параметром является: Ri — внутреннее (выходное) дифференциальное сопротивление представляющее собой сопротивление транзистора между стоком и истоком (сопротивление канала) для переменного тока,
На пологих участках выходных характеристик Ri достигает сотен килоом и оказывается во много раз больше сопротивления транзистора постоянному току Ro.
Следующий важный параметр — коэффициент усиления, который показывает, во сколько раз сильнее действует на ток стока изменение напряжения затвора, нежели изменение напряжения стока
Коэффициент усиления m выражается отношением таких изменений ∆Uси и ∆Uзи, которые компенсируют друг друга по действию на ток стока Iс, в результате чего этот ток остаётся постоянным. Так как для подобной компенсации ∆Uси и ∆Uзи должны иметь разные знаки (например, увеличение Uси должно компенсироваться уменьшением Uзи, то в правой части формулы (5.7) стоит знак «минус». Иначе, вместо этого можно взять абсолютное значение правой части, т.e. m >0. Коэффициент усиления m связан с параметрами Ri и S простой зависимостью
К параметрам полевого транзистора, которые, как правило, указываются в справочной литературе, относятся:
Iс.нач — начальный ток стока, ток стока при напряжении между затвором и истоком, равном нулю, и при напряжении на стоке, равном или превышающем напряжение насыщения;
Iс.оcт — остаточный ток стока при напряжении между затвором и истоком, превышающем напряжение отсечки;
Iз.ут— ток утечки затвора, ток затвора при заданном напряжении между затвором и остальными выводами, замкнутыми между собой;
Iзио — обратный ток перехода затвор-исток. при разомкнутом выводе, ток, протекающий по цепи затвор-исток, при заданном обратном напряжении между затвором и истоком и разомкнутыми выводами.
Uзиотс — напряжение отсечки полевого транзистора, напряжение между затвором и истоком транзистора с р-n-переходом или МДП транзистора со встроенным каналом, при котором ток стока достигает заданного низкого значения;
Uзипор- пороговое напряжение полевого транзистора, напряжение между затвором и истоком МДП — транзистора с индуцированным каналом, при котором ток стока достигает заданного низкого значения;
Rсuoтк — сопротивление сток-исток в открытом состоянии транзистора, сопротивление между стоком и истоком в открытом состоянии транзистора при заданном напряжении сток-исток, меньшем напряжения насыщения.
Указанные параметры можно определить экспериментально либо по статистическим вольт-амперным характеристикам. В справочниках нередко приводят только один из видов характеристик. Чаще всего стоковые характеристики Ic=f(Ucи) при Uзи=const .
Рассмотрим пример построения семейства стоко-затворных характеристик Ic=f(Uзи) при Ucи=const для полевого транзистора КП312Б (рис.5.6,а,б). Графическими построениями находим значения токов и напряжений и заносим в табл.5.1
| Uзи, В | -0,25 | -0,5 | |||
| Из рис.5,6,а | Uси = 0,4 В | Iс , мА | 1,1 | 0,75 | 0,55 |
| Uси =1,2 В | Iс , мА | 2,2 | 1,4 | ||
| Uси =1,6 В | Iс , мА | 2.4 | 1,6 | 1,1 | |
| Из рис. 5,6,б | Uси =5 В | Iс , мА | 2,8 | 1,9 | 1,3 |
| Uси =10 В | Iс , мА | 1,3 | |||
| Uси =15 В | Iс , мА | 1,3 |
По полученным данным строим семейство кривых, обозначающих зависимость Ic=f(Uзи) при Uси =const (рис.5.б,в). Если в справочнике приведены только стоко-затворные характеристикиIc=f(Uзи) при Uси =const , то, используя их, можно построить семейство выходных характеристик.
Рассмотрим пример построения семейства стоковых характеристик Ic= f(Ucи) при Uзи =const. по известному семейству стоко-затворных характеристик транзистора КП601 (рис.5.7,а). По графикам определяем значения токов и напряжений и заносим в табл.5.2.
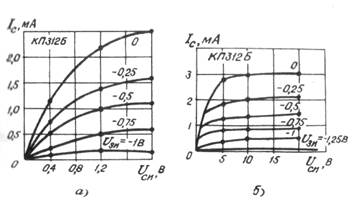 |
 |
| Uси, В | 0,5 |
| Uзи=-8В | Iс, мА |
| Uзи=-4В | Iс, мА |
| Uзи=-2В | Iс, мА |
| Uзи=0В | Iс, мА |
По полученным данным строим семейство кривых, обозначающих стоко-затворные характеристики Ic=f(Uзи) при Uси = const (5,7,б).
Рассмотрим пример определения параметров S, Ri, μ и Rо транзистора КП10З по выходным стоковым характеристикам.
Задаем режим работы транзистора по постоянному току (задаем положение исходной рабочей точки).
Ucио=-8В, Uзио = 1В (5.9)
Наносим положение ИРТ на характеристику Uзи=1В=const при Uси =-8В и определяем (рис.5.8) ток стока: Iсо = 0,4 мА (5.10)
Определение параметра S
В соответствии с формулой (5.4) для выполнения условия Ucи = const выше и ниже ИРТ на характеристике Uзи = 0,5В и Uзи=1,5 В выберем две точки, для которых Uси=-8В (см, рис.5.8)
Для т.А: Uзиа = 0,5В ; Iса=0,8мА; Ucиа=-8В.
Для т.В:Uзив = 1,5В ; Iсв = 0,15 мА; Ucив = -8В. (5.11)
Для ИРТ:Uзио = 1,0В ; Iсо = 0,4 мА; Ucио = -8В.
Как видно, для всех трех точек выполняется условие Ucи =-8 В = const. По графикам (см.рис.5.8) определяем приращение ∆Uзи и ∆Ic между точками т.А и т.В и находим крутизну S :
Согласно справочным данным для транзистора КП103 крутизна составляет S=0,4. 3,0мА/В.
Определение параметра Ri
В соответствии с формулой (5.5) для выполнения условия) Uзи =const выберем на характеристике Uзи = 1,0 В две точки левее и правее ИPT (рис.5.9)
Для т.С: Uси с = -12В ; Iсс = 0,42 мА; Uзис=1,0 В.
Для т.Д:Uси д = -4В ; Iсд = 0,38 мА; Uзид = 1,0В. (5.13)
Для ИРТ:Uсио = -8В ; Iсо = 0,4 мА; Uзио = 1,0 В.
Как видно для всех трех точек выполняется условие Uзи = 1,0 В =const.
По графикам (см.рис.5.9) определяем приращения ∆Ic и ∆Ucи и находим параметр Ri
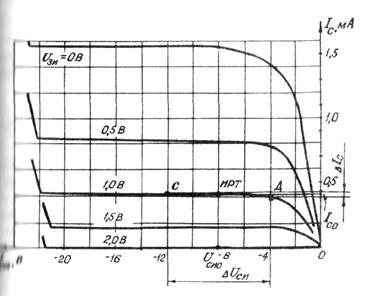 |
Определение параметра μ
В результате того, что коэффициент усиленияμ имеет довольно большую величину, то его нередко невозможно измерить в указанной рабочей точке. Тогда коэффициент μ находят по формуле (5.8) после определения параметров S и Ri
μ = S Ri = 0.65мА/в 200 кОм =130 (5.15)
Действительно, легко проверить, что для такого значения μ изменению напряжения сток-исток на 4 вольта (∆Uси = 4 В) соответствует изменение напряжения затвор-исток ∆Uзи = 30 мВ. По вольт — амперным характеристикам такие вычисления можно выполнять только при малом значении μ.
Определение параметра Rо
Сопротивление транзистора постоянному току определяем для заданной рабочей точки как отношение постоянного выходного напряжения Ucио к соответствующему постоянному выходному току Iсо по формуле (5.6) (см.рис.5.8)
Следует подчеркнуть, что значения рассчитанных параметров зависят от выбранного положения ИРT. Для подтверждения на рис.5.10 приведен график зависимости крутизны S от тока стока Iсо для транзистора КП313. Читатель может убедиться в этом и непосредственно, рассчитав значение крутизны S по изложенной выше методике для различных положений ИРТ.
Данные параметры можно определить и по семейству сток-затворных характеристик. Рассмотрим на примере транзистора КП313 для рабочей точки:
Uзио = 1В, Uсио=10 В (5.17)
Наносим положение ИРТ на характеристику Uси=10В=const при Uзи=1В и определяем ток стока (рис.5.11): Iсо = 10 мА (5.I8)
В соответствии с формулой (5.4) для выполнения условия Ucи =const выберем две точки т.А и т.В на характеристике Ucи = 10В (см.рис.5.11).
Для т.А: Uзиа = 1,3 В;Icа = 12,5мА; Uсиа = 10 В
Для т.А: Uзив = 0,7 В;Icв = 7,5мА; Uсив = 10 В (5.19)
Для ИРТ: Uзио = 1 В; Icо = 10мА; Uсио = 10 В
Видно, что для всех трех точек выполняется условие Uси =10В=const. По графикам (см.рис.5.11) определяем приращение ∆Uзи и ∆Ic между точками т.А и т.В и определяем крутизну S.
Для сравнения: по справочнику у транзистора КП313 крутизна S составляет
S = 4,5 . 10,5 мА/В . (5.21)
Определение параметра Ri
Для определения параметра Ri в соответствии с формулой (5.5) для выполнения условия Uзи = const выберем т.С на характеристике Uси = 15 В, соответствующую Uзи =1В (рис.5.12)
Для т.С: Uсис = 15В; Icc = 11мА;Uзис = 1В (5.22)
Для ИРТ: Uсио = 10В; Icо = 10мА;Uзио = 1В

Для этих двух точек выполняется условие Uзи = 1В = const. По графикам (см. рис.5.12) находим приращения ∆Ic и ∆Uси и определяем параметр Ri
Определение коэффициента усиления μ
Для определения коэффициента усиления μ в соответствии с формулой (5,7) для выполнения условия Ic = const выберем на характеристике Ucи = 15 В точку т.Д, для которой Ic = 10 мА (рис. 5,13)

Для т.Д: Uсид = 15В; Uзид = 0,85В; Iсд = 10мА (5.24)
Для ИРТ: Uсио = 10В; Uзид = 1В; Iсо = 10мА
Для этих двух точек выполняется условие Iс = 10мА=const.
По графикам (см.рис.5.13) находим приращения ∆Uзи и ∆Ucи и определяем коэффициент усиления μ..
Расчет по формуле (5.8)
μ = S Ri = 8,3 мА 5кОм = 41,5 (5.26)
дает удовлетворительное согласование с (5.25). Небольшие расхождения обусловлены неизбежными погрешностями графических построений и не играют существенной роли. Как уже отмечалось выше, существует разброс параметров у транзисторов.
| | | следующая лекция ==> |
| КОНВЕНЦИОНАЛИЗМ А. ПУАНКАРЕ (1854-1912) | | |
Дата добавления: 2015-11-20 ; просмотров: 5333 ; ЗАКАЗАТЬ НАПИСАНИЕ РАБОТЫ
http://lektsii.org/17-68018.html
http://helpiks.org/5-112717.html





 МДП−транзистора со встроенным каналом n−типа.
МДП−транзистора со встроенным каналом n−типа.



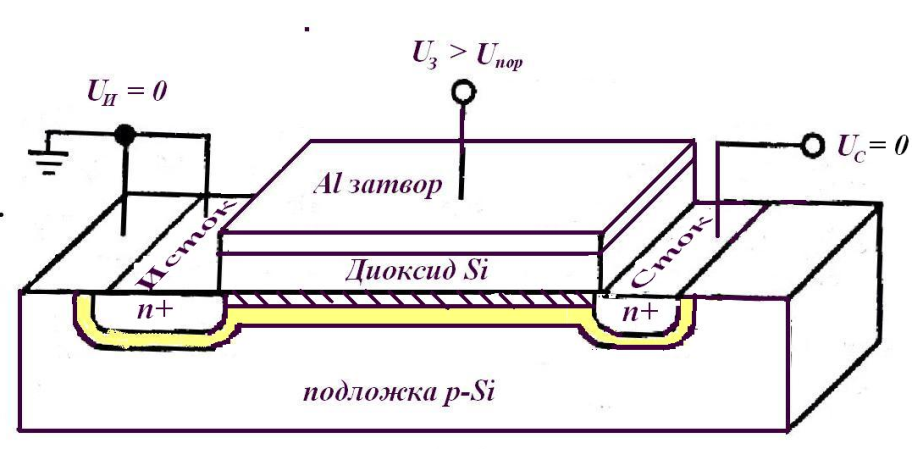
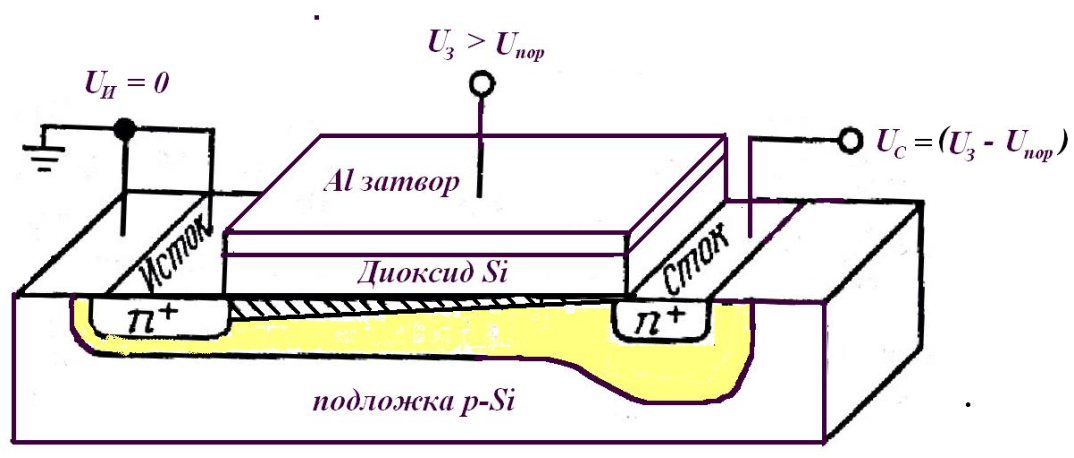



 (9-5)
(9-5) где Еох есть напряженность электрического поля в слое окисла под затвором, а lох —толщина этого слоя в сантиметрах.
где Еох есть напряженность электрического поля в слое окисла под затвором, а lох —толщина этого слоя в сантиметрах. (9-6)
(9-6) — плотность поверхностного заряда в Кл/см 2 . Обь
— плотность поверхностного заряда в Кл/см 2 . Обь  единяя формулы (9-5) и (9-6), получим
единяя формулы (9-5) и (9-6), получим (9-7)
(9-7) (9-8)
(9-8) определяется зарядом захваченных отрицательных ионов и подвижных электронов. Примем, что плот
определяется зарядом захваченных отрицательных ионов и подвижных электронов. Примем, что плот  ность ионов примеси мала по сравнению с плотностью
ность ионов примеси мала по сравнению с плотностью  подвижных электронов. Хотя это допущение для реальных устройств ведет к неточным результатам, оно сильно упрощает математическую модель. Удельную проводимость канала в точке х можно выразить следующим образом:
подвижных электронов. Хотя это допущение для реальных устройств ведет к неточным результатам, оно сильно упрощает математическую модель. Удельную проводимость канала в точке х можно выразить следующим образом: (9-9)
(9-9) — поверхностная подвижность электронов в канале. Поверхностная подвижность примерно вдвое меньше объемной подвижности. Причина этого заключается в дополнительных механизмах рассеяния, связанных с близостью поверхности. Будем считать, что поверхностная подвижность электронов постоянна на всем протяжении канала.
— поверхностная подвижность электронов в канале. Поверхностная подвижность примерно вдвое меньше объемной подвижности. Причина этого заключается в дополнительных механизмах рассеяния, связанных с близостью поверхности. Будем считать, что поверхностная подвижность электронов постоянна на всем протяжении канала. (9-10)
(9-10) (9-11)
(9-11) (9-12)
(9-12) (9-14)
(9-14) (9-15)
(9-15) (9-16)
(9-16) (9-17)
(9-17) (9-18),
(9-18), (9-19)
(9-19) 9-20)
9-20) (9-21)
(9-21) = 0 в формуле (9-21)
= 0 в формуле (9-21)  = 0. Для очень малых значений
= 0. Для очень малых значений  , таких, что
, таких, что
 (9-25)
(9-25) МОП полевой транзистор работает в области насыщения (пологий участок ВАХ) с перекрытым каналом. Носители заряда из области канала вытягиваются электрическим полем стока через обедненный слой от точки перекрытия канала в участок стока n+ (для n- канального транзистора). Напряжение на стоке при перекрытом канале равно Uc нас , т.е.:
МОП полевой транзистор работает в области насыщения (пологий участок ВАХ) с перекрытым каналом. Носители заряда из области канала вытягиваются электрическим полем стока через обедненный слой от точки перекрытия канала в участок стока n+ (для n- канального транзистора). Напряжение на стоке при перекрытом канале равно Uc нас , т.е.:
 (9-27)
(9-27) существует квадратичная зависимость.
существует квадратичная зависимость.



 (6)
(6) = ( l з — l к эфф )/2, а h д – толщина подзатворного диэлектрика
= ( l з — l к эфф )/2, а h д – толщина подзатворного диэлектрика
 ( 7)
( 7) (8)
(8) , (9)
, (9) и (9), получим:
и (9), получим: (10)
(10) (11)
(11) — дрейфовая скорость насыщения носителей заряда. Подставляя последнее уравнение в (11) и с учетом (10) получим, что максимальная рабочая частота прибора fm определяется [2]:
— дрейфовая скорость насыщения носителей заряда. Подставляя последнее уравнение в (11) и с учетом (10) получим, что максимальная рабочая частота прибора fm определяется [2]:
 .
. .
. (12)
(12) (13 )
(13 ) — глубина залегания переходов стока и истока, мкм
— глубина залегания переходов стока и истока, мкм — толщина подзатворного диэлектрика, ангстрем
— толщина подзатворного диэлектрика, ангстрем (14 )
(14 )